2019年8月号
新機能ワイドギャップ半導体材料の開拓
- ワイドギャップ半導体
- c-BN
- パワーデバイス
ワイドギャップ半導体であるc-BN(立方晶窒化ホウ素)は、半導体の中でもっとも高い絶縁破壊電界を有しており、高効率なパワーデバイスを実現できる材料として高い可能性を秘めています。NTT物性科学基礎研究所では、独自の成長技術を開発することによって、c-BN薄膜の高品質ヘテロエピタキシャル成長を初めて実現しました。本稿では、その成長技術と、実際のパワーデバイス応用に不可欠なドーピングによるc-BN薄膜の電気伝導性制御について紹介します。
平間 一行(ひらま かずゆき)/ 谷保 芳孝(たにやす よしたか)/ 山本 秀樹(やまもと ひでき)/ 熊倉 一英(くまくら かずひで)
NTT物性科学基礎研究所
ワイドギャップ半導体のパワーデバイス応用
ワイドギャップ半導体は、現在主流の半導体材料であるSi(シリコン)やGaAs(ヒ化ガリウム)では実現できない、低電力損失のパワーデバイスへの応用が期待されている材料です。パワーデバイスは、システムの要求に合わせて電力を直流から交流、交流から直流へと変換したり、直流電圧の昇圧・降圧、交流の周波数変換を行ったりする、電力変換デバイスです。こうしたデバイスは身の回りのいたるところで使われており、例えば、100 Vの交流をPCや携帯端末の駆動・充電に適した20 V前後の直流に変換するACアダプタもパワーデバイスの1つです。パワーデバイスをある特定の電圧で動作させたときの、半導体材料ごとの電力損失の傾向を図1に示します。電力損失は、そのデバイスの動作時の抵抗値(オン抵抗)で決まり、使われている半導体材料のキャリア濃度に反比例し、電流パスの長さに比例します。絶縁破壊電界*1が高い半導体材料ほど、キャリア濃度をより高濃度に、また電流パスもより短くすることができるため、SiやGaAsと比べて、約1桁もしくはそれ以上の高い絶縁破壊電界を有するワイドギャップ半導体を用いると、オン抵抗を3桁以上小さくすることができます。その結果、電力損失(エネルギー損失)が小さく、省エネルギー・高効率なパワーデバイスが作製できることになります。代表的なワイドギャップ半導体はSiC(炭化シリコン)とGaN(窒化ガリウム)です。これらの材料を用いたパワーデバイスは、すでに実用化が進んでおり、例えばSiCは、架線の直流電圧を交流に変換してモーターを駆動する鉄道車両用のインバータなどに使用され始めています。
NTT物性科学基礎研究所では、次世代のワイドギャップ半導体として注目を集めているc-BN(立方晶窒化ホウ素)、AlN(窒化アルミニウム)、ダイヤモンドの研究を行っており、本稿では、半導体中でもっとも高い絶縁破壊電界を有しているc-BNについて紹介します。c-BNを利用したパワーデバイスは、ほかの半導体材料のパワーデバイスと比べて、同じ電圧で動作させたときの電力損失をもっとも小さくすることができます(図1)。SiやGaAsと比べると、動作時の電力損失を4桁以上(実用化が進んでいるSiCやGaNと比べても、さらに1桁以上)低減できるポテンシャルがあります。こうした電力損失の小さい(高効率の)パワーデバイスを、電気自動車や鉄道、また太陽光・風力発電に応用できれば、地球規模でのエネルギー利用の高効率化や資源の有効利用につながり、持続可能な社会の実現に貢献できると考えています。
*1 絶縁破壊電界:絶縁体や半導体材料に印加する電界強度を大きくしていくと、ある電界強度以上で急激に大電流が流れるようになります(絶縁破壊が起こります)。絶縁破壊が起こり始める電界強度を絶縁破壊電界といい、その大きさは材料によって異なります。
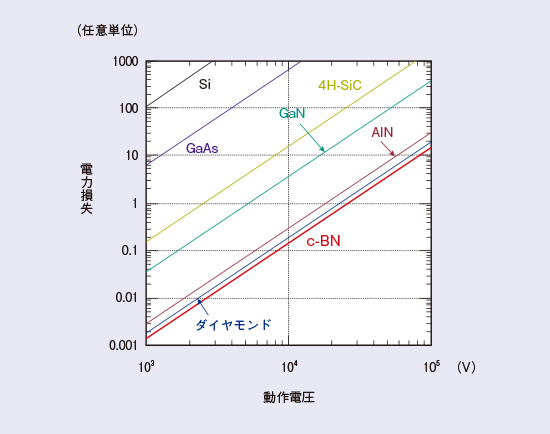
図1 各半導体材料でパワーデバイスを作製したときの動作電圧と電力損失の関係
独自の手法によるc-BN薄膜の成長
BN(窒化ホウ素)は、ホウ素と窒素からなる化合物であり、ホウ素と窒素の結合の仕方や積層の周期の違いによって結晶構造が異なります。代表的な結晶構造は、グラファイトに似た層状構造のh-BN(六方晶窒化ホウ素)と、閃亜鉛鉱構造のc-BNです(図2)。h-BNは、層内はsp2と呼ばれる共有結合、層間はファンデルワールス結合により結合しており、常温常圧下ではもっとも安定な結晶相(常温常圧安定相)です。一方、c-BNは、sp3と呼ばれる共有結合のみからなる高温高圧安定相であり、常温常圧下では準安定な結晶相です。半導体のデバイス応用のための薄膜の作製では、主に、キャリア濃度や膜厚を精密に制御可能な気相成長法が利用されていますが、一般的な気相成長法の成長温度と成長圧力の範囲(1400 ℃以下、1気圧以下)では準安定相であるc-BNの成長は困難です。気相成長法においても、試料表面にイオンを照射(イオンアシスト)しながらBN薄膜を成長することで、高温高圧安定相であるsp3結合相の形成が可能になりますが、熱力学的安定相であるsp2結合相が混入しやすいため、これまでに報告されているBN薄膜にはsp3結合相とsp2結合相の両方が混在していました。
NTT物性科学基礎研究所では、Ar+イオン照射(イオンアシスト)を利用した独自の気相成長手法(イオンビームアシストMBE法)を開発し(図3)、気相成長法でありながらsp2結合相を含まないc-BN薄膜のエピタキシャル成長に成功しました。c-BN薄膜の原料であるホウ素は電子線加熱蒸発源から供給しました。窒素は、N2(窒素分子ガス)ではなく、高周波プラズマ下で生成する、反応性の高い原子状のN*(窒素ラジカル)として供給しています。同時に、イオンソースからはAr+イオンを加速させて供給しています。各原料とイオンの供給量は独立に制御することが可能です。薄膜成長の土台となる基板には、c-BNと格子定数の近いダイヤモンド(001)基板上を用いています(1)、(2)。
まず、成長中のAr+イオン照射の有無によるホウ素と窒素の結合様式の違いを説明します。成長後のBN薄膜のFT-IR(Fourier Transform Infrared Spectroscopy)透過吸収測定*2の結果を図4に示します。Ar+イオン照射を行わずに成長したBN薄膜のFT-IRスペクトルでは、sp3結合に由来する吸収ピークはみられず、1380 cm-1と780 cm-1近傍にsp2結合に由来する吸収ピークのみがみられました。この結果は、すべてのホウ素と窒素の結合がsp2結合であることを意味しており、熱力学的に安定なsp2結合のBN薄膜が成長していることが分かります。一方、Ar+イオン照射を行いながら成長した場合では、sp2結合の吸収ピークはみられず、1070 cm-1近傍にsp3結合に由来する吸収ピークのみがみられます。このことから、すべてのホウ素と窒素の結合はsp3結合になっており、sp2結合を含まないBN薄膜となっていることが分かります。このように、N*によるホウ素の窒化だけではホウ素と窒素の結合はすべてsp2結合となりますが、同時にAr+イオンを照射することでsp3結合のみを選択的に形成することが可能です。成長中のイオン照射によってsp3結合が形成されるメカニズムはいまだ明らかではありませんが、イオン照射による運動エネルギーまたは運動量を受けて高いエネルギー状態になったホウ素と窒素どうしが結合して直接sp3結合を形成しているか、sp2結合が運動エネルギーまたは運動量を受けてsp3結合になっているかのどちらかだと考えています。
原子配列の規則性の有無が分かる断面透過電子顕微鏡(TEM: Transmission Electron Microscope)観察の結果を図5に示します。sp3結合のみのBN薄膜は、基板として用いたダイヤモンド(001)基板上に均質に成長しています。薄膜部分の制限視野電子線回折のパターンは、理論的に予測されたc-BN(001)の制限視野電子線回折パターンと、スポットの位置と間隔の点で一致することから、形成された薄膜が、単結晶のc-BN(001)薄膜であること、また、ダイヤモンド(001)基板の原子配列を引き継いでエピタキシャル成長していることが明らかになりました(3)。
*2 FT-IR透過吸収測定:サンプルに赤外光(IR)を照射し、透過した光と入射した光量の差から、サンプルに由来する赤外光の吸収を評価する測定手法。検出器で検出した広い波長範囲のIRを一括してフーリエ変換(FT)することでスペクトルに変換しています。

図2 h-BNとc-BNの結晶構造モデル
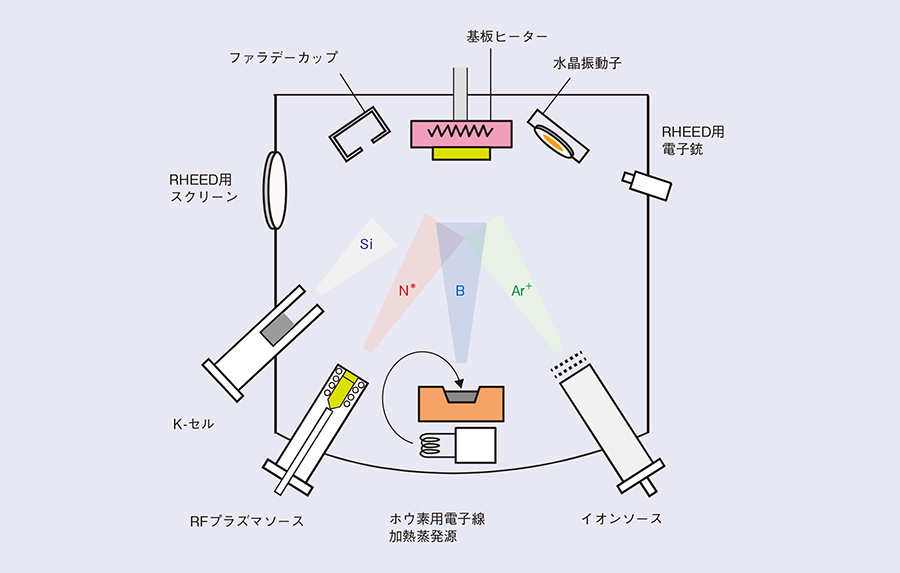
図3 イオンビームアシストMBE装置の模式図
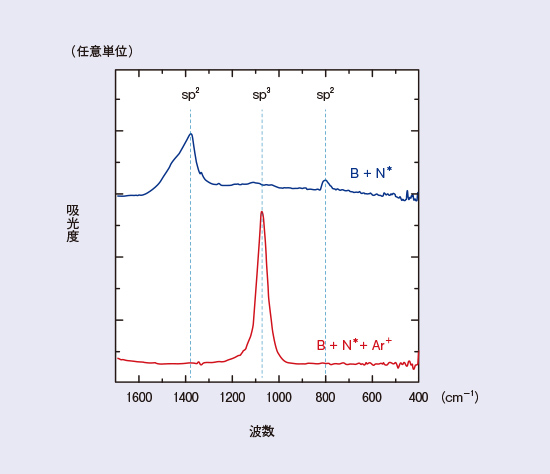
図4 イオン照射の有無によるFT-IR透過吸収スペクトルの違い
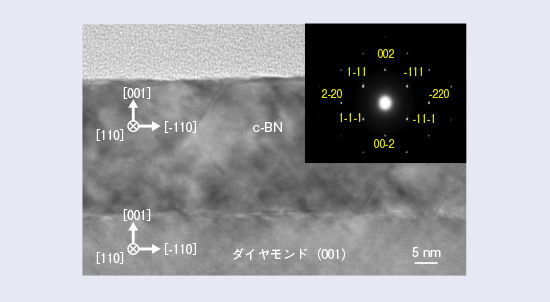
図5 断面TEM像とc-BN領域の制限視野電子線回折像
c-BN薄膜の電気伝導性制御
デバイスを作製するためには、単にc-BNの高品質薄膜を成長するだけではなく、そこにアクセプタやドナーになる不純物をドーピングして、p型やn型半導体をつくる必要があります。そこでまず、n型c-BN薄膜の成長を目的として、c-BN中でドナーとなることが知られているSiをドーピングしました。Siは、c-BN薄膜成長中にクヌーセンセル(K-セル)*3から供給しています。
シリコン濃度([Si])が1.2×1018 cm-3のc-BN薄膜のキャリア濃度の温度依存性を図6に示します。室温と500 ℃におけるキャリア濃度は2.1×1015 cm-3および6.0×1017 cm-3であり、温度に対してキャリア濃度が単調に増加しています。電荷中性条件の式によるフィッティングから見積もった、ドナーのイオン化エネルギー(ED)、ドナー濃度(ND)、アクセプタ濃度(NA)は、それぞれ、0.20 eV、1.1×1018 cm-3、4.6×1017 cm-3です。NDが、[Si]とほぼ一致していることから、ドーピングしたSi原子のほとんどがホウ素サイトを置換してドナーとして働いていると考えられます。また、フィッティングから得られたEDの値(0.20 eV)は、c-BNと同様に次世代のワイドギャップ半導体として期待されているダイヤモンドやAlNへドーピングした際のEDよりも小さい値です。EDの値が小さいほど、室温でドナーがイオン化しやすく、高いキャリア濃度が得られることから、c-BNを用いると、ダイヤモンドやAlNよりも低損失なパワーデバイスが作製できると期待できます。
室温におけるSiドープc-BN薄膜の抵抗率のSiドーピング濃度依存性を図7に示します。比較のために、意図的なドーピングを行っていない(ノンドープ)c-BN薄膜のデータも記載しています。ノンドープc-BN薄膜は抵抗率が~108 Ω・cmであり、非常に高い絶縁性を示しますが、Siドーピングした[Si]:1.5×1019 cm-3のc-BN薄膜では、約260 Ω・cmの低い抵抗率が得られました。この値は、エピタキシャルc-BN薄膜では現在もっとも低い値です。Si濃度の増加によってc-BN薄膜の抵抗率が系統的に減少していることから、Siドーピングによって、n型c-BN薄膜の電気伝導性を制御できるといえます。電気伝導性制御は実際のデバイス応用にとって必要不可欠であり、c-BN薄膜のデバイス応用への道を大きく拓く成果です。
*3 クヌーセンセル:原料の分子線の供給量を高精度かつ安定に制御可能な抵抗加熱蒸発源。
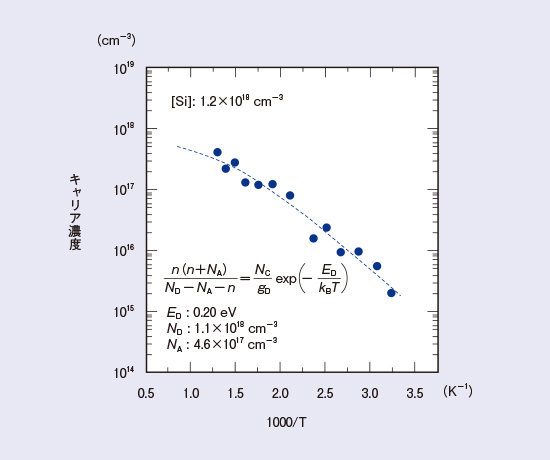
図6 Siドープc-BN薄膜のキャリア濃度の温度依存性

図7 Siドープc-BN薄膜の抵抗率のSiドーピング濃度依存性
今後の展開
本稿では、NTT物性科学基礎研究所が精力的に取り組んでいる新材料研究のうち、c-BN研究の現状について紹介しました。高品質薄膜の成長とドーピング制御の研究の積み重ねにより、現在までに、デバイス応用の足掛かりとなるn型c-BN薄膜の電気伝導性の制御が可能になりました。今後、c-BN薄膜のさらなる結晶性の向上とともに、p型ドーピングや、トランジスタ等のデバイスを作製する研究を通じ、実用化に向けた基盤技術の確立に取り組んでいきます。
■参考文献
(1) 平間・谷保・山本・熊倉:“イオンビームアシストMBE法による立方晶BN(c-BN)薄膜のヘテロエピタキシャル成長、”応用物理、Vol.85, No.4, pp.306-310, 2016。
(2) K. Hirama, Y. Taniyasu, S. Karimoto, H. Yamamoto, and K. Kumakura:“Heteroepitaxial growth of single-domain cubic boron nitride films by ion-beam-assisted MBE、”Appl. Phys. Exp., Vol.10, No.3, 035501, 2017。
(3) K. Hirama, Y. Taniyasu, S. Karimoto, Y. Krockenberger, and H. Yamamoto:“Single-crystal cubic boron nitride thin films grown by ion-beam-assisted molecular beam epitaxy、”Appl. Phys. Lett., Vol.104, No.9, 092113, 2014。

(左から)平間 一行/谷保 芳孝/山本 秀樹/熊倉 一英
問い合わせ先
NTT物性科学基礎研究所
機能物質科学研究部
TEL 046-240-3356
FAX 046-240-4929
E-mail kazuyuki.hirama.gz@hco.ntt.co.jp




c-BNは、高効率のパワーデバイスへの応用が期待できる産業上重要な半導体材料ですが、一方で、その物性や結晶成長機構はいまだ完全には解明されていません。今後は、独自のc-BN成長技術をさらに高めてパワーデバイス応用の研究を加速させながら、そうした学術的な課題の解決にも取り組んでいきます。