2019年8月号
原子層物質のCVD成長技術
- 原子層物質
- 化学気相堆積法
- 結晶方位制御
グラフェンや六方晶窒化ホウ素(h-BN)などの原子層物質は、従来のエレクトロニクス材料を凌駕する電気・光学特性さらには新奇物性を有するなど、既存デバイスの高性能化のみならず新機能デバイス創製の可能性を秘める次世代のエレクトロニクス材料です。産業応用に向けて、原子層物質を大面積で高品質に作製する手法の確立が望まれています。本稿では、高品質グラフェン単結晶の大面積化、結晶方位制御によるh-BNの高品質化技術を紹介します。
Shengnan Wang/ 谷保 芳孝(たにやす よしたか)
NTT物性科学基礎研究所
原子層物質
原子層物質は原子1個もしくは数個分の厚みしかない層状の物質です(図1)。代表的な原子層物質であるグラフェンはC(炭素)原子が蜂の巣のような六角形格子状に連なった構造からなり、厚さが原子1個分しかない究極的に薄い単原子層の物質です(1)。グラフェンは、線形分散の電子のエネルギーバンドを有し、非常に大きな電荷移動度(電気伝導性)や赤外から可視光の広い領域で波長無依存の大きな光吸収性などユニークな特性を示します。さらには、物質中最大級の熱伝導性、機械的強度を有しています。
グラフェン以外にも、MoS2(硫化モリブデン)、MoSe2(セレン化モリブデン)、MoTe2(テルル化モリブデン)、WS2(硫化タングステン)、WSe2(セレン化タングステン)、WTe2(テルル化タングステン)などの遷移金属ダイカルコゲナイド(TMDC: Transition Metal Dichalcogenides)や、半導体デバイスに用いられるSi(シリコン)やGe(ゲルマニウム)の原子が層状に配列したシリセンやゲルマネンなど数多くの原子層物質が存在します。例えば、TMDCは単層が原子3個分の厚みの物質で、バンドギャップが層数によって変化する特異な物性を有する半導体です。また、TMDCは大きなスピン軌道相互作用に由来するスピンに依存した電気伝導や偏光特性を有しています。
h-BNは、周期表で炭素の両隣りのB(ホウ素)とN(窒素)からなる化合物であり、グラフェンと同じく六角形格子状の結晶構造からなる単原子層物質です。h-BNは約6 eVの大きなバンドギャップを持つ絶縁体であり、絶縁膜やトンネル障壁として機能します。さらに、h-BN上にグラフェンやTMDCを積層すると、グラフェンの電荷移動度が向上すること、TMDCの発光強度が増加することが報告され、h-BNは原子層物質の性能を最大限に引き出すために欠かせない物質です。
現代社会を支えるシリコン半導体デバイスの微細化が限界に近づきつつある中、原子層厚で機能を発現できる原子層物質への期待が高まっています。さらに、原子層物質には、金属、超伝導体、磁性体から半導体、絶縁体まで多種多様な電子材料が存在し、また、光学的機能はテラヘルツから赤外・可視・紫外の広い光領域をカバーしています。そこで、軽くて曲げられるフレキシブルデバイス、高速・省電力の超小型トランジスタ集積回路や大容量メモリ、高効率の発光デバイス・発電デバイス、小型軽量の超高感度センサなど、高度情報化社会の発展に資するデバイスへの原子層物質の応用が期待されています。
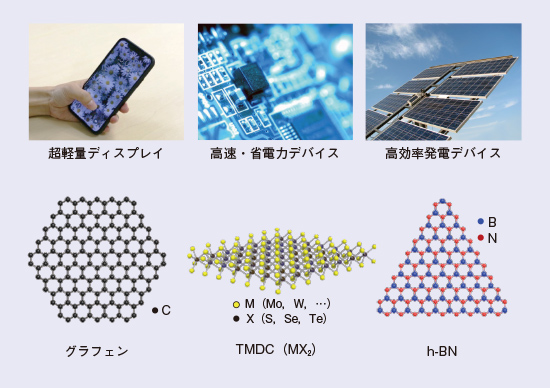
図1 原子層物質とそれらの応用例
原子層物質の作製手法
原子層物質の作製方法として、剥離転写法や薄膜成長法など各種提案があります。図2に示しますように、剥離転写法は、天然に存在する、もしくは、人工的に合成された微結晶(粉末)から粘着テープを用いて原子層を劈開し、Si等の基板上に転写する方法です。コンスタンチン・ノボセロフとアンドレ・ガイムの両博士は、この簡便な方法でグラファイト(黒鉛)からグラフェン1層分を引き剥がして、グラフェンの特異な物性を実証し、ノーベル物理学賞を受賞しています。本手法により、原子層物質の基礎物性が次々と解明されるとともに、デバイス応用の可能性が示されてきました。しかし、本手法で得られる原子層物質の大きさは、微結晶のサイズにより制限されるため一般的に数10 μmと小さいうえ、手作業での剥離転写のため再現性とスループットに乏しく、集積デバイスの産業化には不向きです。そこで、剥離転写法に代わり、原子層物質を高品質かつ大面積に再現性良く形成する技術の開発が望まれています。
薄膜成長法の1つである化学気相堆積法(CVD: Chemical Vapor Deposition)は、ガス状の原料を加熱した基板上に供給し、化学反応により物質を合成する手法です。原料はガス状で供給されるため大きな基板にも全面に均一に広がることから、CVDは大面積成長に適しており半導体デバイスの量産製造プロセスで広く利用されています。原子層物質でもCVD成長の技術開発は進められています。現状では、原子層物質を大面積基板の全面に形成できるものの、結晶方位のそろっていない結晶粒が合体した多結晶のため品質は低く、また、各結晶粒の大きさは剥離転写法と同程度の数10 μmと小さいなど課題があります。本稿では、NTT物性科学基礎研究所が取り組んでいる原子層物質CVDに関して、グラフェン単結晶の大面積化技術、h-BNの結晶方位制御技術を紹介します。
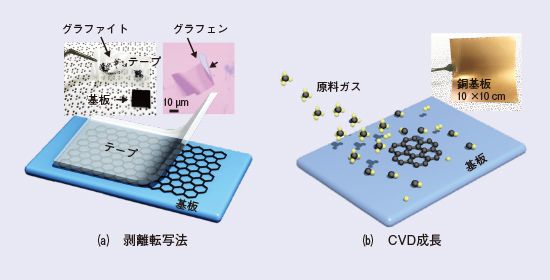
図2 原子層物質の作製手法
グラフェン単結晶の大面積化技術
グラフェンのCVD成長の概略を図3(a)に示します。銅基板を反応炉内に導入後、Ar(アルゴン)やH2(水素)、もしくはこれらの混合ガス中で成長温度(約1000 ℃)まで加熱します。その後、銅基板表面に自然に形成されているCu2O(亜酸化銅)などの酸化膜をエッチング(除去)するためのアニールを行い、炭素原料であるCH4(メタンガス)を導入して、グラフェンの成長を開始します。成長を開始すると、銅基板表面のいたる所でグラフェンの結晶核が形成します。成長を継続すると、グラフェンの結晶核サイズは拡大し(結晶核が大きくなると結晶粒と呼びます)、近くの結晶粒と合体することで、グラフェンは銅基板表面全体を覆います。核形成密度が低いほど、近接する結晶核間の距離が離れることから、大きな結晶がつくられます。核密度は成長温度、原料供給量などのグラフェンの成長条件に依存することが知られています。
一方、グラフェンは酸化膜上では核形成せず、酸化膜が除去された銅表面上で核形成します。ガス種によって酸化膜のエッチング速度は異なり、Arガスよりも還元性の高いH2ガスのほうが酸化膜のエッチング速度は大きくなります。グラフェン成長前の銅基板のアニールをArガスのみで行い、銅基板表面の酸化膜を完全に除去せず被覆状態をアニール時間により調整したところ、グラフェンの核形成密度を精密に制御できるようになり、図3(b)に示しますように従来よりも100倍大きい、ミリメータサイズのグラフェン単結晶を作製することに成功しました(2)。本グラフェンを用いて電界効果トランジスタ(FET: Field Effect Transistor)構造を試作したところ、従来のCVD手法で作製した数10 μmサイズのグラフェンよりも電荷移動度は10倍近く高く、また、剥離転写法のグラフェンを用いて作製したFETと同程度の特性が得られました。これらの結果は、本手法が高品質のグラフェン単結晶の大面積化に有望であることを示しています。
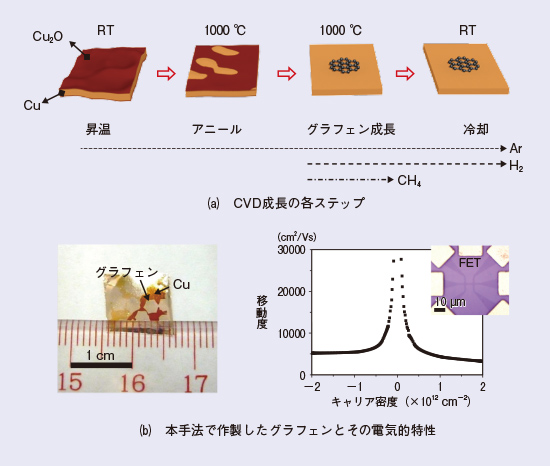
図3 グラフェン単結晶の大面積化
h-BNの結晶方位制御技術
h-BNは、グラフェンと同様に、銅基板上にCVD法を用いて成長しました。BNを合成する場合、原料にはH6BN(アンモニアボラン)を用いました。一般的に、CVD成長する物質の結晶方位は基板の結晶構造、結晶面方位に強く依存します。銅は面心立方格子構造の結晶です。市販されている銅基板は多結晶ですが、CVD成長のアニール過程において、銅基板は加熱により再結晶化します。再結晶化では、多結晶の結晶粒どうしが合体して大きくなり、また、基板表面では結晶粒の特定の結晶面が現れています。例えば、銅の代表的な結晶面の(001)、(101)、(111)面上では、結晶面の回転対称性を反映して、結晶方位が2方向または4方向にそろう多方位のh-BNが形成します。結晶方位の異なる結晶粒どうしが合体する場合、それぞれの結晶粒は原子レベルで結合できず、粒界に欠陥が発生します。
100種類以上の異なる結晶面上に成長したh-BNの結晶方位を系統的に調査したところ、(101)面から傾いた結晶面上にh-BNを成長した場合、図4(a)右側の顕微鏡像に示しますように、三角形状のh-BN結晶粒がすべて同じ方向を向いた、結晶方位が一方向にのみ配向する単一方位のh-BNが成長することを発見しました(3)。理論計算から、傾いていない(101)面上では原子が安定に吸着できる格子位置が2パターンあるためh-BNの結晶方位が2方向を取り、(101)面から傾いた結晶面上では結晶表面の対称性が破れることから安定な吸着位置は1パターンとなり単一方位のh-BNが形成することを明らかにしました。この単一方位に配向するメカニズムは、h-BNだけでなく、すべての原子層物質に応用できる原理になります。
図4(b)はh-BNの電気抵抗をミクロスケールで評価した結果です。単一方位h-BNは多方位h-BNよりも電気抵抗が高く、良好な絶縁性を有することが分かりました。多方位h-BNでは、結晶方位の異なる結晶の粒界で欠陥に起因して電流が流れやすく、絶縁性が悪くなっています。単一方位のh-BNでは、結晶核どうしが原子レベルでシームレスに結合するため結晶性が高く、均一な絶縁性を示します。
図4(c)に示しますように、基板全面を単層h-BNが覆うまでCVD成長を継続すると、多方位の場合には所々に複数層のh-BNが意図せず形成してしまい不均一な膜になりますが、単一方位に制御することで単層のみの均一性の高いh-BN膜を形成することができます。絶縁性に優れ、均一性の良いh-BNは、原子層物質デバイスの安定動作、性能向上に欠かせないことから、本手法はh-BNの基盤技術になることが期待されます。
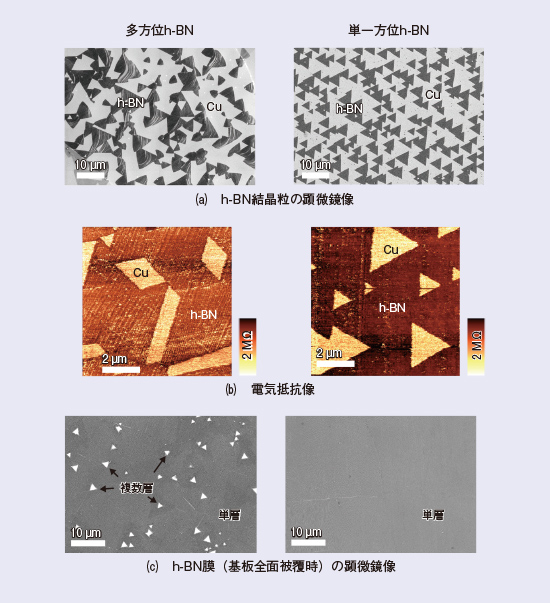
図4 h-BNの結晶方位制御
今後の展開
原子層物質のデバイス応用に向けては、多種多様な原子層物質それぞれのCVD技術を高めていく必要があります。最近、原子層物質を積層した縦型ヘテロ構造において、それぞれの層の結晶方位の差(回転角)に依存して物性値が大きく変化したり、異なる電子状態に転移(相転移)したりすることが分かってきました。この原子層物質特有の現象を利用した新機能デバイスを創製するには、CVD成長した大面積h-BN上に所望の機能を発現できる原子層物質を回転角制御してCVD成長する技術が必要になってきます。さらに、単原子層面内で異なる物質を自由自在にCVD成長する横型ヘテロ成長技術を確立できれば、1次元ヘテロ界面や面内超格子構造に由来する新たな物理現象の発見につながっていくことが期待できます。
■参考文献
(1) 日比野:“グラフェン研究への取り組み、” NTT技術ジャーナル、Vol.25, No.6, pp.6-8, 2013。
(2) S. N. Wang, H. Hibino, S. Suzuki, and H. Yamamoto:“Atmospheric Pressure Chemical Vapor Deposition Growth of Millimeter-Scale Single-Crystalline Graphene on the Copper Surface with a Native Oxide Layer、”Chem. Mat., Vol.28, No.14, pp.4893-4900, 2016。
(3) S. N. Wang, A. E. Dearle, M. Maruyama, Y. Ogawa, S. Okada, H. Hibino, and Y. Taniyasu:“Catalyst‐Selective Growth of Single‐Orientation Hexagonal Boron Nitride toward High‐Performance Atomically Thin Electric Barriers、”Adv. Mater., Vol.31, No.24, 1900880, 2019。

(左から)Shengnan Wang/谷保 芳孝
問い合わせ先
NTT物性科学基礎研究所
機能物質科学研究部
TEL 046-240-3497
FAX 046-240-4718
E-mail yoshitaka.taniyasu.ry@hco.ntt.co.jp




NTT独自技術で創製した物質やナノ構造に秘められた新奇物性を解き明かし、新物質の学理の構築、新機能デバイスの提案により、物質科学・工学の最前線を開拓していきます。