2026年3月号
特集1
AlN系分極ドープトランジスタの高周波動作
- 窒化アルミニウム
- 高周波増幅器
- 分極ドーピング
窒化アルミニウム(AlN)系窒化物半導体は、極めて高い絶縁破壊電界を持ち、次世代無線通信に向けた高出力・高周波デバイス材料として注目されています。しかし、高Al(アルミニウム)組成領域では従来の不純物ドーピングによる伝導性制御が困難となり、高周波トランジスタ動作の実現は長年の課題でした。本稿では、窒化物半導体に特有の分極を利用した、新しい伝導性制御手法である分極ドーピングについて解説し、本手法によりAlN系トランジスタの高周波動作を実証した最新の研究成果を紹介します。
川崎 晟也(かわさき せいや)/廣木 正伸(ひろき まさのぶ)
平間 一行(ひらま かずゆき)/谷保 芳孝(たにやす よしたか)
NTT物性科学基礎研究所
情報社会を支える高周波半導体デバイス
誰しも一度は、スマートフォンを家に忘れた、充電がない、といった状況に陥り、困り果てた経験があるのではないでしょうか。メッセージ送受信や情報検索だけでなく、娯楽や金融、商品の売買等々、いまや身の回りのありとあらゆるモノ・コトがインターネットに接続され、情報通信技術は私たちの生活とは切っても切り離せないものになっています。
こうした情報は光ファイバ等を用いた有線通信ネットワークあるいは、電波*1を用いた無線通信ネットワークによってやり取りされています。特に無線通信においては、2019年から5G(第5世代移動通信システム)サービスが開始され、モバイル端末でやり取りされるデータ量は増加の一途をたどっています。2030年代には現在(2025年)の約2倍になると予想されています。このため、2030年以降の社会・産業を支えるべく、さらなる無線移動通信システムの高度化がBeyond 5Gとしてめざされています。
Beyond 5Gでは、陸上だけでなく空・海・宇宙を含むあらゆる場所での利用を想定し、これまでの無線通信ネットワークではカバーできなかったエリアへのカバレッジの拡張が求められています。そうした背景から、静止軌道衛星(GEO)や、低軌道衛星(LEO)、成層圏プラットフォーム(HAPS)を用いて陸・海・空・宇宙の通信ネットワークを構築する非地上系ネットワーク(NTN:Non Terrestrial Network)が注目されています。NTNでは長距離無線伝送技術が必須となります。電波は伝搬損失により距離とともに減衰するため、NTNの実現には、高周波で高出力を得られる増幅器が重要な役割を担います。
図1は半導体、および真空管を用いた増幅器の動作周波数と出力を示したものです。窒化ガリウム(GaN)半導体を用いたHEMT(High Electron Mobility Transistor)*2は、高出力半導体増幅器として優れた特性を示しています。GaN系HEMTは携帯電話の基地局向けデバイスとして、広く普及しており、また、一部のLEO衛星の送信用増幅器として用いられています。一方で、より高出力が求められる衛星通信用途では、進行波管増幅器といった真空管増幅器が依然として用いられています。しかしながら、真空管増幅器は大型、短寿命、衝撃に弱い等々の課題があります。したがって、GaN系HEMTを凌駕する超高出力・高周波半導体増幅器を実現できれば、既存の真空管デバイスを置き換えることが可能となり、増幅器の小型化、長寿命化を通じて、堅牢な無線通信ネットワーク網の構築が期待されます。
*1 電波:電波法では周波数300万MHz、つまり3THz以下の電磁波と定義されています。数100MHz–30GHzまでをマイクロ波帯、30–300GHz帯をミリ波帯、それより高い周波数帯をテラヘルツ帯と呼び分ける場合もあります。これまでの通信はマイクロ波帯が中心でしたが、今後はミリ波帯、テラヘルツ帯の活用がめざされています。
*2 HEMT:高電子移動度トランジスタ。半導体高周波トランジスタとして広く用いられています。
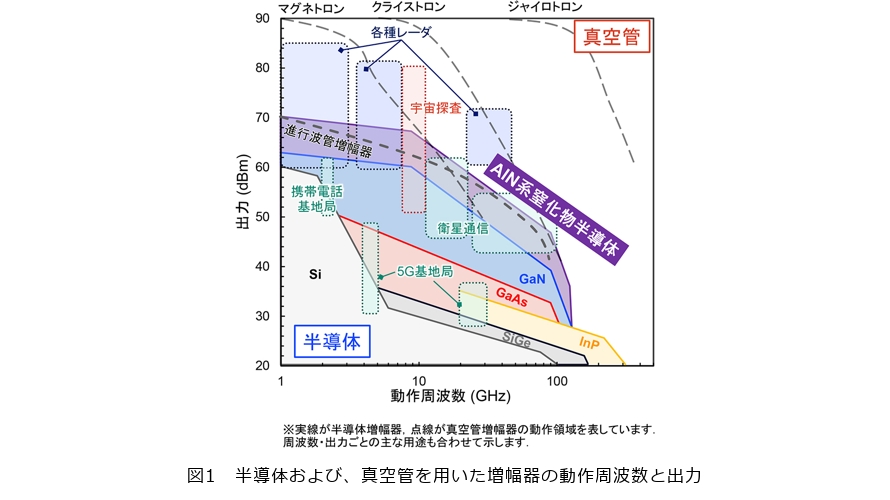
AlN系窒化物半導体への期待
高出力な高周波半導体増幅器を実現するためには、高い周波数で動作し、かつ高い電圧を印加できるトランジスタが求められます。そのためには、絶縁破壊電界*3と飽和電子速度*4が高い半導体材料が適しています。
本研究では、従来の半導体材料では実現し得なかった超高出力動作が可能な高周波増幅器を実現し得る材料として窒化アルミニウム(AlN)系窒化物半導体、AlNおよびGaNとの混晶で、Alの組成が50%を超えるAlGaNに着目しています。AlNは少なくとも7 MV/cm以上、期待値としては12 MV/cmもの半導体中で最大級の絶縁破壊電界を持っており、電子飽和速度も107cm/sと高い値を持っています。そのため、高出力・高周波トランジスタとしての性能指数であるJohnson性能指数は図2で示すように半導体中で最大級であり、SiやGaAsと比較すると桁違いであることはもちろん、GaNと比較しても5倍の高い性能が期待されます。つまり、同一周波数にてGaNの5倍の高出力化が見込まれます。このようにAlNは高出力・高周波デバイス材料として非常に魅力的な材料といえます。
しかしながら、AlN系窒化物半導体は、電子デバイスとして利用するうえで、伝導性制御が困難である、という欠点を持っています。そのためトランジスタでの電流の通り道であるチャネル層のAl組成を高めていくと、抵抗が高くなるという問題を抱えています。そうした背景から、Al組成が75%を超えるような高Al組成では、高周波トランジスタの作製・動作は困難と考えられていました。
これに対して私たちは、分極ドーピングという、従来の半導体とは異なる伝導性制御手法を用いたAlN系分極ドープ電界効果トランジスタ(pol-FET:polarization-doped Field-Effect Transistor)に注目し、高Al組成のAlGaNでも低抵抗なチャネル層を実現、AlN系高周波トランジスタの作製・動作に成功しました(1)。
*3 絶縁破壊電界:半導体材料に電圧をかけた際に、電気的な絶縁を保てなくなり急激に電流が流れ始める電界強度です。この値が高いほど高電圧・高出力で動作します。
*4 飽和電子速度:強電界下で電子が到達できる最大速度です。電子速度が速いほど高い周波数(高速)で動作します。
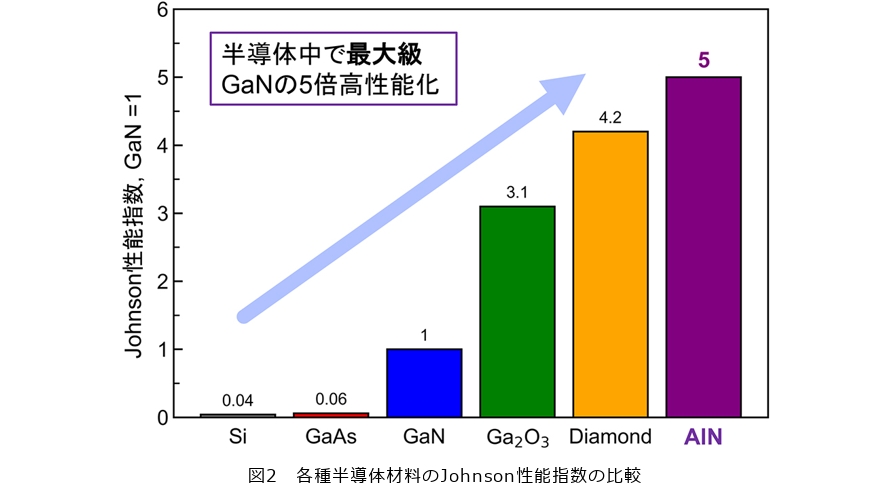
AlN系窒化物半導体の分極ドーピング
半導体材料は用途に合わせて、電流の担い手となる電子(負電荷)や正孔(正電荷)のキャリア濃度を非常に広い範囲でかつ精密に制御する必要があり、その際に不純物と呼ばれる元素を結晶中に導入するドーピングを行います。高電圧を印加するパワーデバイスであれば1014–1016cm−3、ここで取り上げている高周波デバイスであれば1018cm−3を超えるようなキャリア濃度(不純物濃度)の制御が求められます。不純物はそのままでは電気的には働かず、キャリア生成にはある程度の熱エネルギーを必要とします。この目安をイオン化エネルギーといい、Siでは50 meV、GaAsでは数meV–30 meVであり、室温(25 ℃)の熱エネルギー25.7 meVと同程度です。このため、SiやGaAsでは不純物は十分にイオン化し、導入した不純物濃度とほぼ同じキャリア濃度を得られます。
しかしながら、AlN系窒化物半導体は、高Al組成領域でイオン化エネルギーが100 meVを超え、室温では不純物のほとんどがイオン化しません(図3)。例えば、n型のAlNでは不純物を1018cm−3ドーピングしても生成されるキャリアはそのうちわずか0.1%の1015cm−3程度です。これでは高周波デバイスに求められる低抵抗な半導体膜を得られず、AlN系窒化物半導体本来の特性を発揮できません。
そこで、私たちは従来の不純物ドーピングによらない、新しい伝導性制御手法を用いています。それが分極ドーピングです。
GaNも含めAlN系窒化物半導体は、窒素原子の強い電気陰性度により、イオン結合性を示します。その結果、結晶中ではGaやAlのⅢ族原子は正に、窒素原子は負に帯電しています。結晶構造は図3中に示すようにⅢ族原子と窒素原子が四面体構造をとりますが、その格子定数の比(図3中のcとaの比)が1.626–1.601と正四面体の1.633から変位しています。そのため、イオン結合による電気双極子モーメントが打ち消されず、結晶内で自発分極と呼ばれる電荷の偏りが生じます。また、GaN上にAlGaN層やAlN上にAlGaN層など、格子定数の異なる半導体材料を積層すると、上層は下層の影響を受け、引張や圧縮の応力が印加されます。この歪により、結晶構造がさらに変位するため、ピエゾ分極として追加で分極が誘起します。分極ドーピングはこうした窒化物半導体の分極効果を利用した伝導性制御手法であり、その基本原理はJenaらによって2002年に提案されました(2)。
図3に分極ドーピングによるAlGaNのn型伝導性制御の例を示します。ここでは、[0001]方向(c軸方向)にAl組成が上昇する組成傾斜AlGaN層を考えます。
AlNはGaNよりも大きい分極を持っているため、AlGaN中の分極はAl組成が高くなるほど大きくなります。そのため、ユニットセルごとに分極の大きさに不整合が生じ、それが組成傾斜層全体に分布します。この場合はユニットセル界面で隣り合う正・負の分極電荷を比較すると正の分極電荷のほうが多いため、正味の電荷として、その差分に対応する正電荷が組成傾斜AlGaN層中に分布しているとみなせます。ただし、この正電荷は半導体結晶中を自由に動けない固定電荷であるため電気伝導には寄与しません。これは分極電荷が半導体結晶を構成する原子そのものに紐付いているためです。一方で、半導体は正と負の電荷がつり合い、電気的に中性となっている必要があります。そのため、この正の固定電荷と釣り合うように組成傾斜層に負の電荷を持つ電子が誘起されます。この電子は組成傾斜層全体に3次元上に一様に分布することから3次元電子ガス(3DEG:3-Dimentional Electron Gas)と呼ばれ、半導体結晶中を自由に動き回ることができます。そのため、半導体の電気伝導に寄与し、この組成傾斜AlGaN層はn型伝導性を示します。また、この3DEG濃度は組成傾斜の勾配、つまり組成の差(分極の差)と膜厚により容易にかつ精密に制御可能です。
このように、分極ドーピングは、不純物を一切用いない伝導性制御手法です。そのため、前述したイオン化エネルギーに縛られることなく、AlN系窒化物半導体においても1018cm−3を超えるキャリア密度を容易に得ることできます。したがって、分極ドーピングはAlN系窒化物半導体デバイスの高性能化に非常に有用な手法となります。

AlN系窒化物半導体の分極ドープFET
図4に分極ドープAlGaNをチャネル層としたAlN系pol-FETのデバイス構造の模式図と、その電子顕微鏡像を示します。デバイス構造は炭化ケイ素(SiC)基板上に有機金属気相成長法(MOVPE法)*5により成長させました。
本構造では、分極ドープによる3次元電子ガスの生成を最大化させるための独自構造として、チャネル層の下部には電荷制御AlGaN下地層を、上部にはAlN障壁層を形成していることがポイントです(3)。電荷制御AlGaN下地層はチャネル層以外で発生する余計な固定電荷の影響を抑える働きが、AlN障壁層はチャネル層がデバイス最表面に露出することによる悪影響を抑える働きがそれぞれあります。容量―電圧特性から見積もった分極ドープAlGaNチャネル層の3DEG濃度を図5(a)に示します。75%を超える非常に高いAl組成においても、2–4×1018cm−3の高濃度3DEGを形成できており、分極ドーピングによる低抵抗なチャネルを実現しました。
このデバイスには先ほど述べた高濃度3DEGを得られる分極ドープチャネル構造以外にも、
① “高品質なAlN系窒化物半導体の成長技術”
② “電極からチャネルへの良好な電流注入を実現するオーミック接触技術”
③ “注入した電流を制御するための理想的なショットキー接触技術”
といった、私たちのグループでこれまで培ってきたさまざまな独自技術が盛り込まれています(4)~(6)。
図5(b)に作製したAlN系pol-FET(チャネルのAl組成85%)の電流―電圧特性(出力特性)を示します。これらの技術により、高Al組成85%のAlGaNチャネルにおいても、線形性の優れた電流の立ち上がりと、500 mA/mmを超える大きなドレイン電流を実現しました。一方、トランジスタは大電流を流すだけでなく、ゲート電圧により、それをオフすることも求められます。作製したAlN系pol-FETは図5(c)に示すように漏れ電流のない良好な伝達特性を示しており、1010を超えるオン・オフ比を得られています。この高いオン・オフ比はトランジスタをより高い周波数で動作させられる1つの指標となります。
図6(a)に高周波特性を示します。高周波増幅器としては、電力増幅が可能な最大動作周波数(fmax)*6が重要な性能指標であり、今回作製したAlN系pol-FETではミリ波帯に対応する79GHzを得ました。
これにより、図6(b)に示すように、従来は困難であった75%を超える高Al組成のAlGaNチャネルを持つ高周波トランジスタの電力増幅動作を世界で初めて、かつ実用的な周波数帯にて実現しました。また、得られたfmaxはこれまで報告されているAlN系高周波トランジスタの中で最高値です。したがって、今回考案したAlN系pol-FET構造は、AlN系窒化物半導体が本来持つ高いポテンシャルを存分に引き出すデバイス設計指針を与えるものであり、AlN系高出力高周波トランジスタの応用に向けて重要な成果となります。
さらに、より高いAl組成89%においても、fmax=61GHzの電力増幅動作が得られました。Al組成89%のAlGaNの禁制帯幅(バンドギャップエネルギー)は約5.6 eVであり、これは、従来高周波電力増幅動作が報告されている半導体材料の中でもっとも大きい値です。本成果は、従来デバイスよりも高出力動作が期待できるウルトラワイドバンドギャップ半導体高周波増幅器として、AlN系pol-FETが有望であることも示しています。
*5 有機金属気相成長法:窒化物半導体薄膜を成長する手法の1つです。III族原料としてトリメチルアルミニウムやトリメチルガリウムなどの有機金属を、窒素原料にはアンモニアを用います。高品質な薄膜を大面積に均一性良く得られるため、量産性に優れ、広く用いられています。
*6 電力増幅が可能な最大動作周波数(fmax):トランジスタが電力増幅器として働ける限界の周波数(電力ゲインが0dBとなる周波数)です。高周波増幅器や無線通信回路の設計で重要な指標となります。正確には最大発振周波数、maximum oscillation frequencyの略ですが、分かりやすさを優先してこのように表現しています。
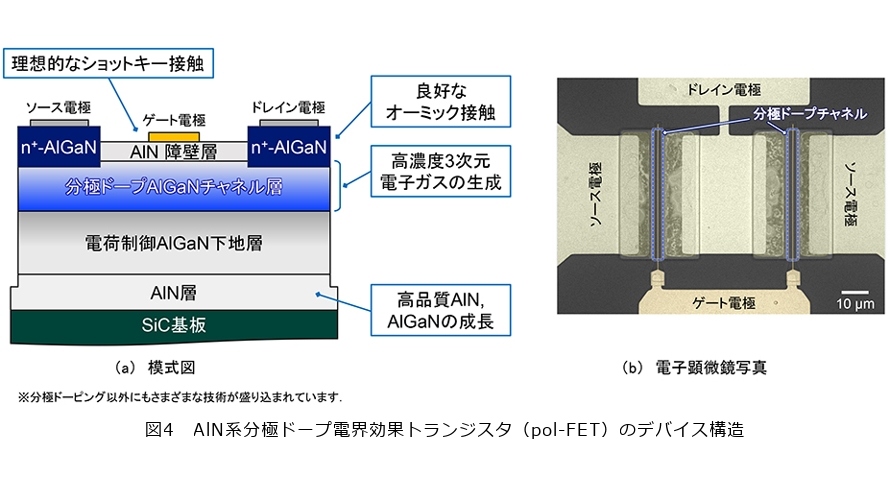
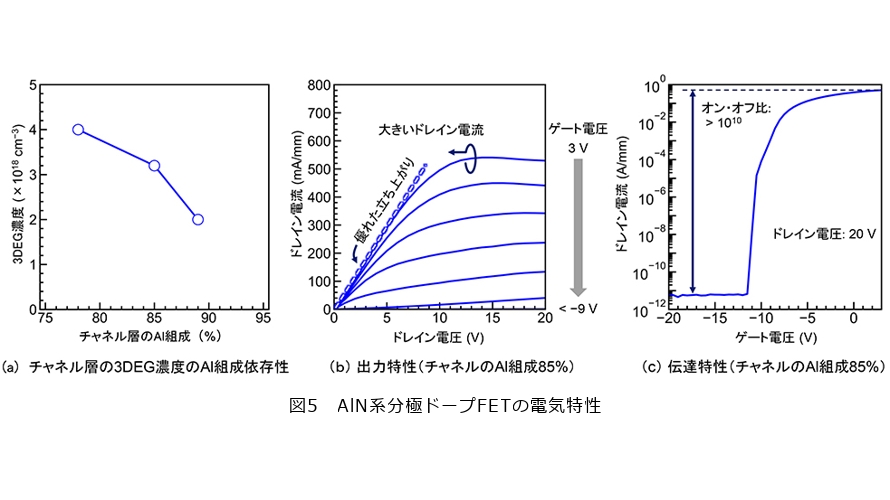
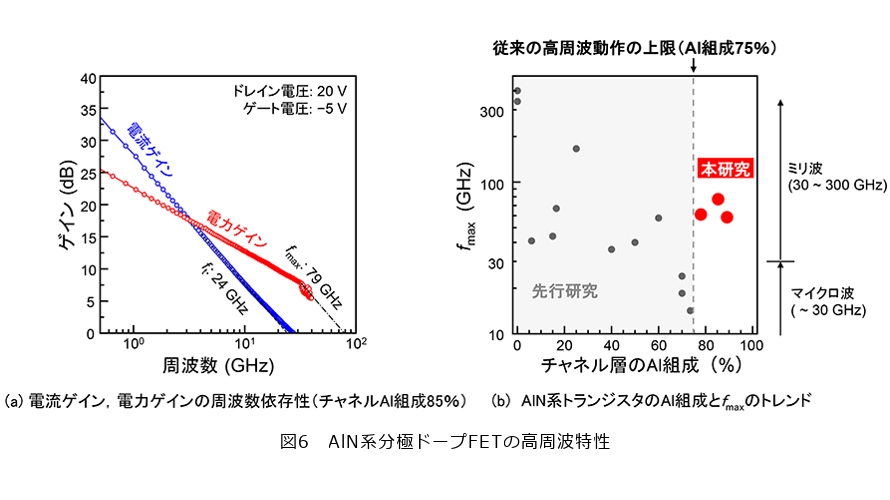
今後の展望
本稿では、AlN系窒化物半導体を用いた高周波トランジスタについて紹介しました。分極ドーピングにより高Al組成領域でも大電流動作および高周波動作が可能なことを示しました。
今後は高電圧動作も同時に実現できるよう、デバイス構造の改善・提案に取り組んでいき、AlN系窒化物半導体のポテンシャルを100%引き出すことで、従来半導体を凌駕する高出力動作の実現をめざします。
高出力・高周波増幅器は通信だけでなく、レーダや宇宙探査など幅広い領域で利用されています。したがって、日常生活に近いところから遠いところまで、さまざまな場面でAlN系高周波トランジスタの活躍が期待できます。その期待を実現できるよう研究に取り組んでいきます。
■参考文献
(1) S. Kawasaki, M. Hiroki, K. Hirama, and Y. Taniyasu: “First RF Operation of AlGaN-channel Polarization-Doped FETs with Average Al-content over 0.75,” IEDM 2025, San Francisco, U.S.A., Dec. 2025.
(2) D. Jena, S. Heikman, D. Green, D. Buttari, R. Coffie, H. Xing, S. Keller, S. DenBaars, J. S. Speck, U. K. Mishra, and I. Smorchkova: “Realization of wide electron slabs by polarization bulk doping in graded III–V nitride semiconductor alloys,” Appl. Phys. Lett., Vol. 81, No.23, pp.4395-4397, 2002.
(3) M. Hiroki, K. Hirama, K. Kumakura, and Y. Taniyasu: “AlN-based polarization-doped field-effect transistors with downward-graded AlGaN underlayers,” Appl. Phys. Lett., Vol. 126, No.20, 202108,2025.
(4) Y. Taniyasu, M. Kasu, and T.Makimoto: “An aluminium nitride light-emitting diode with a wavelength of 210nanometres,” Nature, Vol. 441, No.7091, pp. 325-328,2006.
(5) M. Hiroki and K. Kumakura: “Ohmic contact to AlN:Si using graded AlGaN contact layer,” Appl. Phys. Lett., Vol. 115, No.19, 192104, 2019.
(6) T. Maeda, Y. Wakamoto, I. Sasaki, A. Munakata, M. Hiroki, K. Hirama, K. Kumakura, and Y. Taniyasu: “Thermionic Field Emission in a Si-Doped AlN SBD with a Graded n+-AlGaN Top Contact Layer,” IEDM 2024, San Francisco, U.S.A., Dec. 2024.

(左から)川崎 晟也/廣木 正伸/平間 一行/谷保 芳孝







窒化物半導体は従来の半導体では到達不可能であった光波長、動作温度、高出力を実現し、半導体デバイスの動作領域を拡大してきました。高出力・高周波という真空管デバイスの最後の牙城を崩し、半導体デバイスの動作領域をさらに拡大すべく取り組んでいきます。