2026年3月号
特集1
新規ウルトラワイドバンドギャップ窒化物半導体の創製
- 立方晶窒化ホウ素スカンジウム
- パワーデバイス
- 新材料探索
NTT物性科学基礎研究所では、持続可能社会の実現に貢献することをめざし、省エネルギー電子デバイス向けの新規半導体材料の結晶成長技術開発にも取り組んでいます。本研究では、ウルトラワイドバンドギャップ半導体である立方晶窒化ホウ素(c-BN)に着目し、その機能拡張を目的としてc-BN系新規混晶材料である立方晶窒化ホウ素スカンジウム(c-BScN)のエピタキシャル成長に世界で初めて成功しました。これらのc-BN系半導体は、次世代パワーデバイスへの応用が期待できます。
前田 亮太(まえだ りょうた)/谷保 芳孝(たにやす よしたか)
平間 一行(ひらま かずゆき)
NTT物性科学基礎研究所
次世代パワーデバイス応用に向けた新規窒化物半導体材料研究
ホウ素(B)と窒素(N)は、周期表上で炭素(C)の両隣に位置する元素です。炭素原子は、原子どうしが強い共有結合をつくることで、極めて硬い結晶であるダイヤモンドになります。同様に、BとNも共有結合を形成し、ダイヤモンドと同じ立方晶構造*1(図1(a))をとります。このときにできる材料が、立方晶窒化ホウ素(c-BN:cubic Boron Nitride)です。
c-BNは、ダイヤモンドに次ぐ硬さを持ち、電気の流れを制御できる半導体としての性質も併せ持っています。このc-BNは半導体では最大級のハンドギャップエネルギー(6.25 eV)を持っており、ウルトラワイドバンドギャップ半導体*2と呼ばれています。このバンドギャップエネルギーが大きいほど、半導体材料が耐え得る電圧の指標である「絶縁破壊電界」も高くなる傾向があります。c-BNでは約17.5 MV/cmの絶縁破壊電界が予測されており、この値は既存材料と比べても非常に高く、c-BNが高電圧動作を必要とするパワーデバイスに適した材料であることを示しています(1)。
パワーデバイスとは、電気の直流と交流の変換や直流の電圧レベル制御といった電力変換を行う電子デバイスであり、電気で動く製品の「心臓部」の役割を担っています。こうしたパワーデバイスは、家電製品の電源回路から電車や電気自動車のモータを制御するインバータまで、身の回りのいたるところで使われています。そのため、こうしたパワーデバイスの動作時の損失電力の低減は、地球規模での省エネにつながり、持続可能社会の実現に大きく貢献します。これまでパワーデバイス材料としてシリコン(Si)半導体が主に利用されてきましたが、近年では、Si よりも絶縁破壊電界が高い炭化ケイ素(SiC)や窒化ガリウム(GaN)といったワイドバンドギャップ半導体*2を利用したパワーデバイスの研究開発が加速しており、電車や電気自動車を含めて幅広い分野で用いられるようになっています。これは絶縁破壊電界が高い半導体を利用したパワーデバイスほど、高電圧動作が可能であることに加えて、損失電力が小さい(高効率な)電力変換が可能であるためです。絶縁破壊電界がSiCやGaNよりも5倍以上高いことが予測されているc-BNは、SiCやGaNよりもさらに損失電力が小さく、より高効率なパワーデバイスへの応用が期待できます。さらに、c-BNは化学的に非常に安定であり、高温や放射線にも強いという特長を持っています。このため、通常の使用環境に限らず、宇宙や原子力発電所などの過酷な環境における応用の可能性もあります。
NTT物性科学基礎研究所ではこうした将来的な応用を見据えて、c-BNの結晶成長研究に長年取り組んでいます。c-BNは優れた半導体特性を持つ一方で、結晶成長が極めて難しい材料として知られていましたが、私たちは独自の結晶成長手法を考案することで、これまでにc-BN薄膜のエピタキシャル成長*3とその電気伝導性の制御に成功しています(2)。c-BNの電子デバイス応用には、c-BN系の「三元混晶材料」の結晶成長も重要です。このc-BN系三元混晶材料とは、c-BNの立方晶構造を維持したまま、B原子の一部を別の原子で置換し、異なる3つの元素からなる半導体材料のことです。混晶は原子の組成を変えることで物性を連続的に調整できるという大きな利点があります。そのため、こうした三元混晶材料を含む半導体ヘテロ構造*4は、その有用性から電子デバイスや発光デバイス、センサデバイスなど、さまざまなデバイスで用いられています。
このような背景から、私たちはc-BN系の三元混晶材料の候補である立方晶窒化ホウ素スカンジウム(c-BScN)の結晶成長に取り組んでいます(図1(b))。窒化スカンジウム(ScN)は、c-BNと同じく立方晶系の材料で、閃亜鉛鉱構造と岩塩構造という2種類の結晶多形を持ちます。これらは電気的な性質が大きく異なり、閃亜鉛鉱構造では約2.5 eV、岩塩構造では約0.9 eVのバンドギャップエネルギーを示します。c-BNとScNの混晶である三元混晶のc-BScNでは、BとScの割合を調整することで、バンドギャップエネルギーを 6.25〜0.9 eVの広範囲で連続的に調整できる可能性があります。さらに、c-BScNとc-BNを積層したヘテロ構造の界面近傍に電気伝導を担うキャリア(電子または正孔)を閉じ込めてその通り道(チャネル)として利用できれば、c-BN系半導体の特長を活かした損失電力が小さいパワーデバイスへの応用も期待できます。
*1 立方晶構造:原子が三次元に規則正しく並び、単位となる原子の並び(単位格子)が立方体の形をしている結晶構造です。
*2 ウルトラワイドバンドギャップ半導体、ワイドバンドギャップ半導体:Si(1.1 eV)よりバンドギャップエネルギーが大きい半導体材料。バンドギャップエネルギーが4eVまではワイドバンドギャップ半導体、それ以上のバンドギャップエネルギーを持つ半導体材料はウルトラワイドバンドギャップ半導体と呼ばれます。
*3 エピタキシャル成長:下地となる結晶(基板)の原子の並びと同じ向き・同じ並び方を保ったまま成長することです。結晶の向きがそろうため、欠陥が少なく、高品質な薄膜をつくりやすいという利点があります。
*4 ヘテロ構造:異なる半導体材料を接合してつくられる構造です。

立方晶窒化ホウ素スカンジウム(c-BScN)のエピタキシャル成長
近年私たちは、これまで培ってきたc-BN結晶成長技術を基盤として、世界で初めてc-BScN薄膜のエピタキシャル成長に成功し、さらに、その組成制御も実証しました(3)。c-BScN薄膜を成長するための基板材料には結晶構造が同じで、格子定数が近いダイヤモンドを用いました。成長方法には薄膜材料の産業応用で広く利用されているマグネトロンスパッタリング法*5を用いています。また、本研究では、ダイヤモンド基板上にc-BN薄膜を成長させ、その上にc-BScN薄膜を成長させる段階的なプロセスを採用しました。
c-BScN薄膜がどのように成長しているのかを調べるため、透過型電子顕微鏡(TEM)を用いた観察を行いました。TEM は、非常に薄くした試料に電子線を透過させることで、原子レベルで結晶構造や各層の重なり方を直接観察できる手法です。図2(a)のTEM像では、ダイヤモンド基板の上に、c-BN薄膜、c-BScN薄膜が順に積み重なって成長している様子が確認できます。図2(b)はc-BScN薄膜領域の制限視野電子線回折像*6です。この結果から、c-BScN薄膜がダイヤモンド基板の結晶構造を引き継いでエピタキシャル成長していることが分かります。c-BScN薄膜中のScの分布状態は、走査透過型電子顕微鏡とエネルギー分散型X線分析(EDS)を組み合わせた元素マッピングにより評価しました(図3)。EDSは、電子線を照射した際に試料から放出される元素固有のX線を検出する手法であり、元素ごとの存在を調べることができます。その結果、ダイヤモンド基板からはC、c-BNバッファ層からはBとN、c-BScN薄膜からはB、Sc、およびNがそれぞれ検出され、層構造に対応した元素分布が確認されました。また、Scはc-BScN薄膜全体にわたって均一に分布しており、特定の領域への偏在はありません。以上の結果から、Scが均一に取り込まれたc-BScN薄膜がダイヤモンド基板上にエピタキシャル成長していることを確認しました。
図4にSc組成の成長温度依存性を示します。各温度で、Scの供給量は同じにしています。Sc組成は図5のようにX線逆格子空間マッピングと呼ばれる結晶構造解析手法を用いて見積もりました。その結果、成長温度が低いほど、c-BScN薄膜中に取り込まれるScの量が多くなることが分かりました。860 ℃で成長した試料におけるSc組成は約1.1%です。このように成長温度によって、c-BScN薄膜中のSc組成を制御できることが分かりました。組成制御は、材料の電気的・機械的な性質を意図的に設計するうえで重要であり、将来的なデバイス応用に向けて基盤となる重要な知見です。一方で、1100 ℃以上の成長温度では、c-BScNとして混ざり合うのではなく、c-BNと岩塩構造を持つScNがそれぞれ別々の結晶として成長しました。このような「相分離」が起こると、Scはc-BScNの結晶中に取り込まれにくくなり、結果として薄膜中のSc組成が低下したと考えられます。
*5 マグネトロンスパッタリング法:真空中で原料にプラズマ中のイオンを衝突させ、その際に叩き出された原子を基板上に堆積させる薄膜成長法です。磁場を用いてプラズマを安定化・高密度化することで、低温でも成膜が可能で、膜厚や組成を精密に制御しやすいという特徴があります。
*6 電子線回折:結晶に電子線を透過させたときに、結晶中の規則正しい原子配列によって電子線が特定の方向に散乱し、点やリング状の模様(回折パターン)が現れる現象です。この回折パターンを解析することで、結晶の構造や結晶の向き(方位)が分かります。
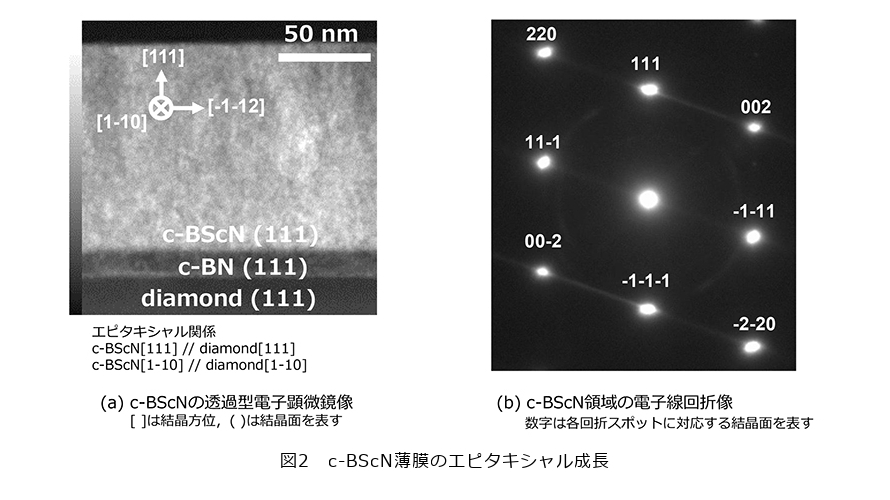
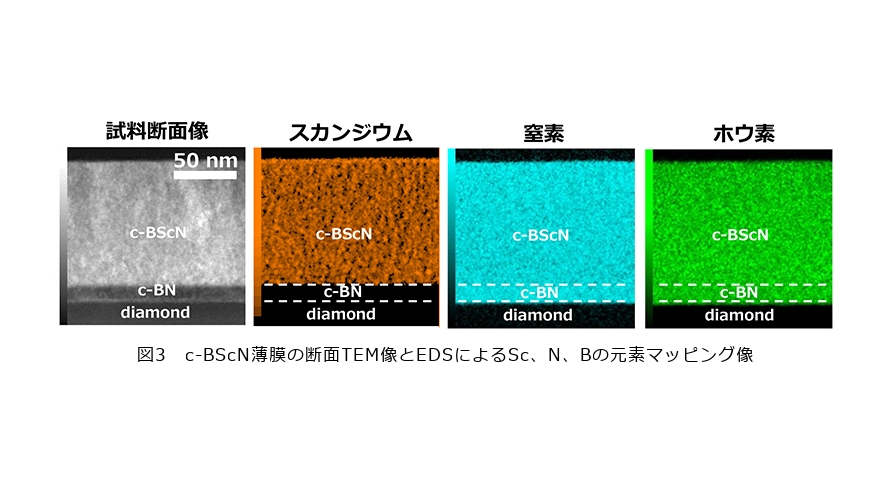


放射光によるc-BScNの結合状態の評価
c-BScN薄膜中におけるSc原子の結合状態を詳しく調べるために、高輝度放射光施設「ナノテラス(NanoTerasu)」においてXAFS(X-ray Absorption Fine Structure)測定を行いました。XAFSは、特定の元素に注目し、その原子の周囲にどのような原子が、どのように配置されて結合しているかを調べることができる手法です。中でも XANES(X-ray Absorption Near Edge Structure)は、原子の結合の仕方や配位数の違いに敏感であり、新材料c-BScN中でSc原子がどのように結晶へ取り込まれているかを明らかにするためには非常に有効です。こうした評価には、高輝度かつ入射するX線のエネルギーを可変できる放射光が不可欠となります。よって、このナノテラスの高輝度放射光を用いることで、ナノメートルオーダーの極薄膜中の元素に対しても、高い信号対雑音比で精密なXANES測定が可能になりました。
図6に示すように、Scの内殻電子に対応するXANESスペクトルを測定したところ、4490 eV付近に特徴的なピークが確認されました。このピークは、Sc原子が4配位構造をとる場合に現れることが知られており、Scが岩塩構造を持つScNのような6配位構造とは異なる結合状態にあることを示しています。さらに、Sc原子がc-BScN結晶中のどの位置に取り込まれているのかをより詳しく理解するために、第一原理計算を用いた解析も行いました。第一原理計算とは、実験データに頼ることなく、量子力学に基づいた物理法則から、原子や電子の振る舞いを計算する理論手法です。この計算を用いることで、「どの原子位置に入るとエネルギー的に安定か」や、「どのような結合状態をとるか」を理論的に予測することができます。本研究では、Sc原子がc-BScN結晶中でN原子の位置に置換した場合と、B原子の位置に置換した場合について、それぞれXAFSスペクトルのシミュレーションを行いました。その結果、Sc原子がN原子の位置にあると仮定した場合のシミュレーションでは、ピークの強度やエネルギー位置が実験結果と大きく異なるのに対し、Sc原子がB原子の位置にあると仮定した場合では、実験結果と近い特徴的なピーク形状が見られました。これらの実験結果と理論計算を総合すると、c-BScN薄膜中のSc原子は、閃亜鉛鉱構造の結晶格子中でB原子の位置を置換して取り込まれていることが示唆されます。本研究で得られたこうした知見は、c-BScNに限らず、他のc-BN 系三元混晶材料を探索する際にも有効です。準安定相材料において、異種元素を結晶格子中へ安定に取り込むための条件設計は、新材料探索を進めるうえで重要な指針となります。
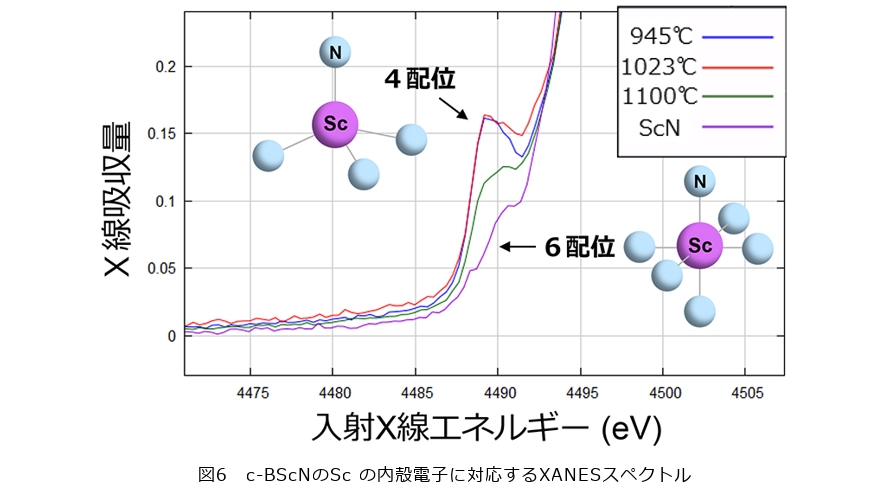
まとめと今後の展望
本研究ではマグネトロンスパッタリング法により、ダイヤモンド基板上へのc-BScN薄膜のエピタキシャル成長と、成長温度によるSc組成制御を世界で初めて実証しました。また、放射光によるXANES測定と第一原理計算を組み合わせることで、Scがc-BN格子中のBサイトに置換して取り込まれていることを明らかにしました。今後は、c-BScNのSc高組成化による物性変調およびc-BN系ヘテロ構造を用いたパワーデバイス応用に取り組みます。
■参考文献
(1) J. Y. Tsao, et al. :“Ultrawide-Bandgap Semiconductors: Research Opportunities and Challenges,”Adv. Electron. Mater.,Vol.4,No.1,1600501,2018.
(2) 平間・谷保・山本・熊倉:“新機能ワイドギャップ半導体材料の開拓,”NTT技術ジャーナル,Vol.31, No.8,pp.29-34, 2019.
(3) 前田・谷保・熊倉・平間:“立方晶窒化ホウ素スカンジウム(c-BScN)薄膜のマグネトロンスパッタリング成長,”第72回応用物理学会春季学術講演会予稿集,17a-K401-9, 2025.

(左から)前田 亮太/谷保 芳孝/平間 一行







自らの手と頭を使い新たな物質を創り出し、その物理的特性を評価することは、たくさんの困難にも直面しますが、それが基礎研究の醍醐味でもあり、世界で初めての実験結果が得られたときには、何ものにも代えがたい喜びを感じます。